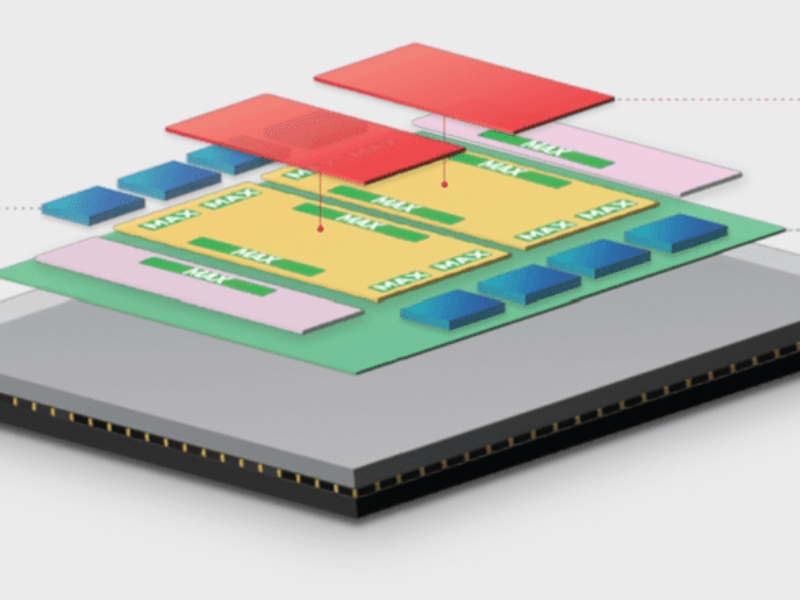
Premier packaging face-à-face en 3,5D pour les processeurs d’IA
Broadcom a combiné pour la première fois la technologie d’empilage de silicium en 3D et la technologie de boîtier face à face en 2,5D pour les processeurs d’intelligence artificielle.
La technologie XDSiP (eXtreme Dimension System in Package) 3,5D intègre plus de 6 000 mm2 de silicium et jusqu’à 12 piles de mémoire à large bande passante (HBM) dans un boîtier pour permettre un calcul IA à haut rendement et à faible consommation d’énergie.
La haute puissance de calcul nécessaire à l’entraînement des modèles génératifs d’IA repose sur des grappes massives de 100 000 à 1 million de dispositifs XPU qui combinent processeurs et accélérateurs d’IA. Ces XPU exigent une intégration de plus en plus sophistiquée des capacités de calcul, de mémoire et d’E/S pour atteindre les performances nécessaires tout en minimisant la consommation d’énergie et le coût.
- Broadcom a plus de cinq de ces produits 3.5D en cours de développement pour les clients, avec des livraisons de production à partir de février 2026.
Au cours de la dernière décennie, l’intégration 2,5D, qui implique l’intégration de multiples chiplets jusqu’à 2500 mm2 de silicium et de modules HBM jusqu’à 8 HBM sur un interposeur, s’est avérée précieuse pour le développement des XPU. Cependant, avec l’introduction de LLM plus complexes comportant des milliards de paramètres, leur formation nécessite un empilement de silicium en 3D pour améliorer la taille, la puissance et le coût.
Densité de signal multipliée par 7
L’emballage F2F permet de multiplier par 7 la densité du signal entre les matrices empilées par rapport à la technologie actuelle face à dos (F2B) et de réduire par de 10 la consommation d’énergie dans les interfaces entre les matrices en utilisant 3D HCB au lieu de PHY planaires entre les matrices.
- Le XPU F2F 3,5D de Broadcom intègre quatre matrices de calcul, une matrice d’E/S et six modules HBM en utilisant les technologies d’emballage CoWoS 2,5D de TSMC. Le flux de conception et la méthodologie d’automatisation propres à Broadcom, fondés sur des outils standard de l’industrie, ont assuré le succès de la première passe en dépit de la complexité de l’appareil.
- Le XDSiP 3.5D a démontré une fonctionnalité complète et des performances exceptionnelles sur les blocs IP critiques, y compris les SerDes à grande vitesse, les interfaces de mémoire HBM et les interconnexions de puce à puce. Cette réalisation souligne l’expertise de Broadcom en matière de conception et de test de circuits intégrés 3.5D complexes.
« Le conditionnement avancé est essentiel pour les clusters XPU de la prochaine génération, car nous atteignons les limites de la loi de Moore. En étroite collaboration avec nos clients, nous avons créé une plate-forme XDSiP 3,5D qui s’appuie sur la technologie et les outils de TSMC et des partenaires EDA », a déclaré Frank Ostojic, Senior Vice President et General Manager de la division ASIC Products de Broadcom. « En empilant verticalement les composants de la puce, la plate-forme 3.5D de Broadcom permet aux concepteurs de puces d’associer les processus de fabrication appropriés à chaque composant tout en réduisant la taille de l’interposeur et du boîtier, ce qui conduit à des améliorations significatives en termes de performances, d’efficacité et de coûts. »
Colaboration TSMC Broadcom
« TSMC et Broadcom ont collaboré étroitement au cours des dernières années pour réunir les processus logiques et les technologies d’empilage de puces en 3D les plus avancés de TSMC avec l’expertise de Broadcom en matière de conception », a déclaré le Dr Kevin Zhang, vice-président senior du développement commercial et des ventes mondiales et co-chef adjoint de la direction de Taiwan Semiconductor Manufacturing Company. « Nous sommes impatients de produire cette plateforme afin de libérer les innovations en matière d’IA et de permettre une croissance future. »
« Avec un partenariat de plus de dix ans, Fujitsu et Broadcom ont réussi à mettre sur le marché plusieurs générations d’ASIC de calcul de haute performance », a déclaré Naoki Shinjo, SVP et responsable du développement des technologies avancées chez Fujitsu. « La dernière plate-forme 3.5D de Broadcom permet au FUJITSU-MONAKA, le processeur de nouvelle génération de Fujitsu basé sur la technologie Arm à 2 nanomètres, d’atteindre de hautes performances, une faible consommation d’énergie et un coût réduit. »
 Si vous avez apprécié cet article, vous aimerez les suivants : ne les manquez pas en vous abonnant à :
ECI sur Google News
Si vous avez apprécié cet article, vous aimerez les suivants : ne les manquez pas en vous abonnant à :
ECI sur Google News




