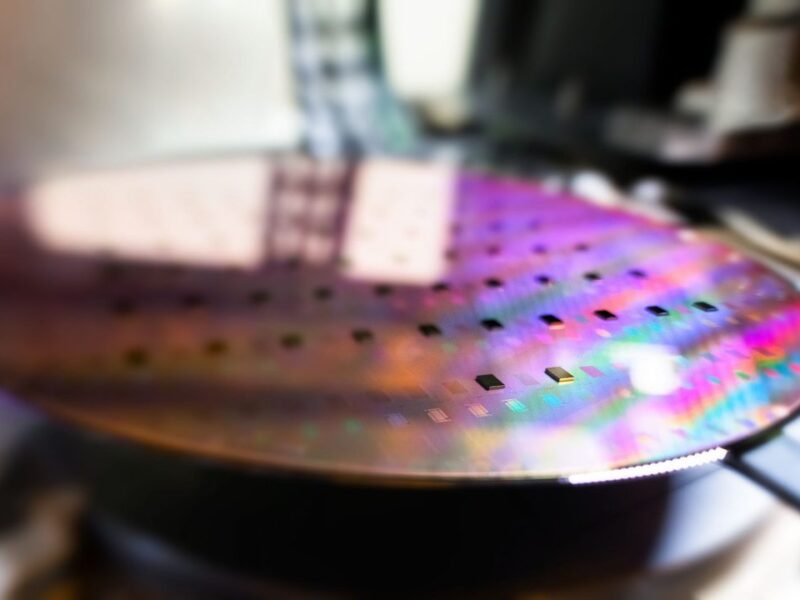
Le CEA-Leti et Intel développent une technique d’auto-assemblage puce-à-wafer
La technique peut augmenter la précision de l’alignement et augmenter le débit de fabrication de plusieurs milliers de puces par heure en utilisant une gouttelette d’eau pour aligner les puces sur un wafer cible.
Le process de liaison hybride D2W est considéré comme essentiel pour combiner la mémoire, le HPC et les chiplets photoniques sur un substrat de wafer, mais il est beaucoup plus complexe que la liaison wafer à wafer, avec une précision d’alignement inférieure et un débit d’assemblage de puce inférieur.
Le CEA-Leti développe depuis plusieurs années une méthode d’auto-assemblage, avec pour objectif d’augmenter sensiblement le débit et la précision de placement.
« Le débit à l’échelle commerciale avec l’auto-assemblage D2W présente deux défis principaux liés à la manipulation des puces », a déclaré Emilie Bourjot, chef de projet d’intégration 3D au CEA-Leti. « Si le process d’auto-assemblage est combiné avec un outil de pick-and-place, le débit peut être augmenté en réduisant le temps d’alignement, puisque l’alignement fin est effectué par la gouttelette. Lorsque l’auto-assemblage est combiné à une solution collective de manipulation des puces, le débit est augmenté par le fait que toutes les puces sont collées ensemble en même temps sans aucun placement de haute précision à tout moment dans le flux du process.
L’optimisation des procédés est également une partie importante de ce travail pour augmenter la maturité des procédés et cibler les exigences industrielles. « Avec de telles performances d’alignement et de débit, c’est définitivement une étape prometteuse alliant la magie de la physique et une simple goutte d’eau », a déclaré Bourjot. Un article présenté cette semaine à la Conférence sur les composants et la technologie électroniques (ECTC) de 2022 décrit la technique qui utilise les forces capillaires qui découlent du principe de minimisation de la surface et s’exercent par la tension superficielle dans le cas d’un liquide.
D’un point de vue macroscopique, le liquide tend à minimiser son interface liquide/air pour atteindre un état d’équilibre avec une énergie minimale. Ce mécanisme permet l’auto-alignement de la puce sur son site de collage. Le liquide choisi comme vecteur de réalignement doit présenter une tension superficielle élevée et doit être compatible avec un collage direct. La plupart des liquides ont une tension superficielle comprise entre 20 et 50 mN/m, à l’exception de l’eau qui présente une tension superficielle de 72,1 mN/m, ce qui en fait un excellent candidat pour les processus d’auto-assemblage par collage hydrophile dans lesquels l’eau est déjà un paramètre clé du mécanisme.
Le CEA-Leti a développé en interne un système D2W qui a montré un désalignement moyen inférieur à 150 nm pour une large gamme de dimensions de puces (8×8 mm², 2,7×2,7 mm2, 1,3×11,8 mm2 et 2,2×11,8 mm2). Cela se compare à un alignement de 1 µm pour un post-bonding d’outil pick-and-place et au meilleur des cas de 700 nm, tandis qu’un processus d’auto-alignement offre un alignement inférieur à 500 nm et même inférieur à 200 nm, post-bonding.
« Comme il n’existe aucun outil industriel pour l’approche de l’auto-assemblage, l’équipe a fabriqué son propre outil permettant un auto-assemblage collectif. Le contrôle manuel du processus à faible reproductibilité a néanmoins atteint un alignement de 500 nm et moins, ce qui suggère fortement qu’un outil industriel dédié à ce processus offrirait une reproductibilité, une robustesse et une précision supérieures », a déclaré le CEA-Leti.
L’objectif du document est d’encourager les fabricants d’équipements d’assemblage à adopter la technologie. « De nombreux aspects de l’auto-assemblage doivent encore être explorés et de grandes améliorations ne seront possibles que lorsque les fournisseurs d’outils développeront (un) outil adapté pour automatiser ce processus », ont déclaré les chercheurs.
www.leti-cea.com; www.intel.com
Related articles
- System-in-package consortium for heterogeneous chiplets
- Intel to expand assembly in France and Italy – reports
- Nexperia spins out its semiconductor equipment business
 Si vous avez apprécié cet article, vous aimerez les suivants : ne les manquez pas en vous abonnant à :
ECI sur Google News
Si vous avez apprécié cet article, vous aimerez les suivants : ne les manquez pas en vous abonnant à :
ECI sur Google News




